Formation and Study of Memristor Elements Based on Copper and Titanium Oxides Using Magnetron Technology
Formation and Study of Memristor Elements Based on Copper and Titanium Oxides Using Magnetron Technology
Abstract
The results of obtaining resistive memory elements on glass substrates are presented. The samples were metal/dielectric/metal structures, the active layer of which was obtained by magnetron sputtering of a composite titanium-copper target. Electron microscopic analysis showed that the active layer after the switching process has a vertically oriented morphology, which may further confirm the filamentary switching mechanism. The volt-ampere characteristics and the effect of resistive switching were studied. It is found that the proposed dielectric layer preparation method is suitable for the fabrication of memristors. In particular, it is demonstrated that the application of these films in the structure of the memristive element allows the ratio of the high electrical resistance state to the low electrical resistance state to be more than 102.
1. Введение
Объем хранящихся в мире цифровых данных за последние десять лет кратно увеличился. Этим обстоятельствам вызван большой интерес к устройствам, демонстрирующим эффекты обратимого резистивного переключения, открывающим путь к созданию сверхъёмких модулей памяти, благодаря наложению нескольких слоев друг на друга, что позволит получить переключающий многомерный и многоканальный механизм, работающий с несколькими слоями одновременно и независимо. Мемристорная память может обладать высокими эксплуатационными характеристиками такими, как быстродействие, энергонезависимость, значительное количество циклов переключения и возможностью сохранять информацию длительное время в широком диапазоне температур , , , , . Вместе с тем поиск материалов диэлектрического слоя мемристора и выбора электродов являются предметом интенсивных исследований
Толкование эффекта резестивного переключения в мемристивных структурах сводится к процессам миграции вакансий кислорода в диэлектрических слоях или ионов металлов, имплантированных в этот слой
, , . Внешнее электрическое поле инициирует образование или разрушение токопроводящих каналов, что и влияет на изменение электрического сопротивления мемристора. Большинство мемристивных устройств на сегодняшний день изготавливаются с использованием различных неорганических , , , и органических материалов , , но одним из первых, и по-прежнему самым популярным, является диоксид титана.В настоящей работе развивается подход к использованию в мемристорных структурах оксидов Ti и Cu, разработанным технологическим режимом осаждения диэлектрика путем магнетронного распыления составной титаново-медной мишени в кислородосодержащей среде.
2. Методика получения и результаты
Конструкция, исследуемых мемристорных структур, представляет собой структуры металл-диэлектрик-металл. В качестве нижнего и верхнего электродов применялся слой алюминия толщиной 70 нм, полученный методом термического испарения. Алюминий был выбран по причине простоты осаждения, к тому же целью данной работы являлось исследование именно диэлектрического слоя. В основе методики формирования активного слоя, рассматриваемых в настоящей работе мемристорных структур, заложены процессы, протекающие в плазме тлеющего разряда, создаваемого магнетронным источником распыления, катодом которого являлась составная мишень Ti:Cu (титан-медь). Схема магнетронной установки проиллюстрирована на рисунке 1. При этом относительная площадь, занимаемая медными дисками на составной мишени, была около ∼15 % от общей площади зоны распыления мишени. Распыление проводилось в атмосфере воздуха при парциальном давлении 6×10-3 мм рт.ст. и токе разряда 150 мА.
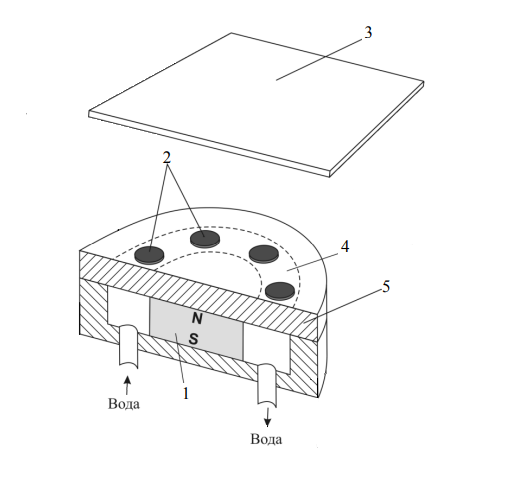
Рисунок 1 - Схематическое изображение магнетронной распылительной системы:
1 – постоянный магнит; 2 – медные диски; 3 – подложка; 4 – зона распыления; 5 – составная мишень (Ti:Cu)

Рисунок 2 - Энергодисперсионный рентгеновский спектр диэлектрического слоя, осажденного магнетронным распылением составной мишени на кремниевой подложке
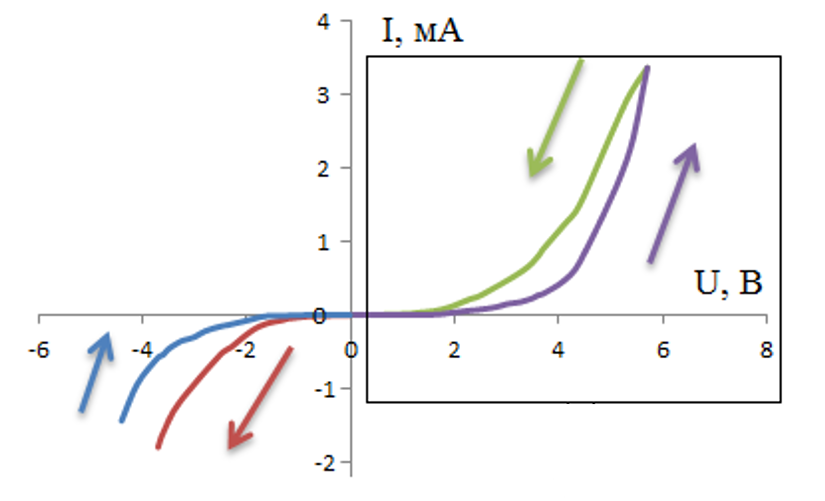
Рисунок 3 - Вольт-амперная характеристика структуры на основе оксида титана:
фиолетовый - при увеличении напряжения; зелёный - в обратном направлении; красный - при увеличении напряжения в отрицательной области; синий - в обратном
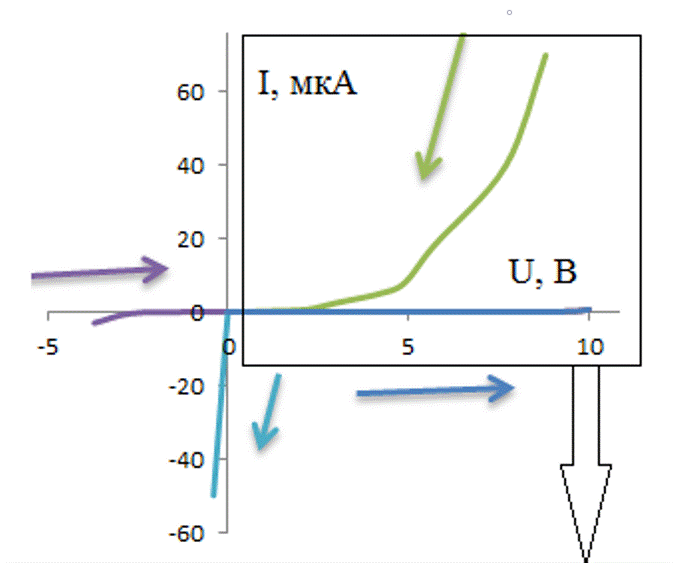
Рисунок 4 - Вольт-амперная характеристика структуры на основе пленок оксида меди с примесями оксида титана, полученного методом магнетронного распыления составной мишени:
синий - при увеличении напряжения; зелёный - в обратном направлении; голубой - при увеличении напряжения в отрицательной области; фиолетовый - в обратном

Рисунок 5 - Зависимость в логарифмическом масштабе для структуры на основе оксида титана:
синяя кривая - при увеличении напряжения; красная - в обратном направлении
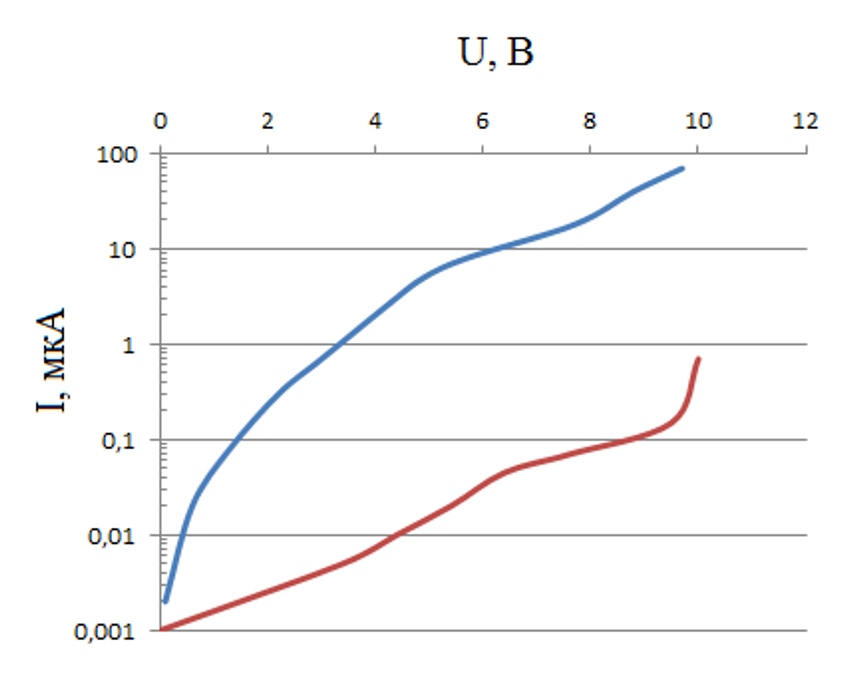
Рисунок 6 - Зависимость в логарифмическом масштабе для структуры на основе пленок оксида меди с примесями оксида титана, полученного методом магнетронного распыления составной мишени:
красная кривая - при увеличении напряжения; синяя - в обратном направлении
Важным стоит упомянуть, что скорость формирования диэлектрического слоя методом магнетронного распыления составной мишени при токе разряда 150 мА составляла 16 нм/мин, что превышает скорость осаждения пленок диоксида титана при том же режиме напыления примерно в 4-5 раз. Этим обстоятельством вызвано преобладание оксида меди в активном слое так как скорость распыления меди кратно больше скорости распыления титана. Толщина диэлектрического слоя при котором проявляется мемристивный эффект таких структур лежит в диапазоне от ∼60 нм до ∼400 нм. На рисунке 4 показана типичная вольт-амперная характеристика мемристора с толщиной диэлектрического слоя ~ 200 нм. Стоит обозначить, что общий вид вольт-амперных характеристик не меняется от изменения толщины активного слоя, а меняется только величина напряжения переключения. По этой причине имеет место сравнительный анализ со структурами без модификаций медью. К тому же характерным для данных пленок является скачкообразный переход в низкоомное состояние.
При исследовании запоминающих свойств данных пленок важно выяснить механизм переключения, реализуемый в представленных структурах. С этой целью было снято растровое изображение торцевого скола структуры с применением TESCAN MIRA 3LMU до и после переключения в низкоомное состояние. Результат представлен на рисунке 7. Можно наблюдать вертикально-ориентируемую морфологию, которая может подтверждать, филаментарный механизм переключения. Стоит упомянуть, что основной причиной нестабильности характеристик мемристорных устройств является неоднородность распределения электрического поля в активном слое мемристора, в связи с отсутствием строгой геометрии в диэлектрическом слое резистивного элемента памяти.
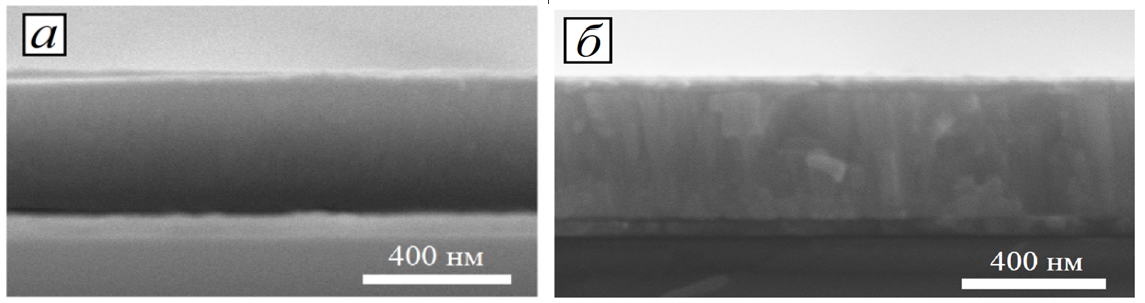
Рисунок 7 - РЭМ-изображение торцевого скола мемристивных структур без воздействия электрическим полем (а), после переключения в низкоомное состояние (б).
3. Заключение
Рассмотрена методика получения пленок оксида меди с примесями оксида титана, полученных магнетронным распылением составной мишени, для создания на их основе мемристорных структур. С применением растровой электронной микроскопии были получены снимки торцевого скола тонкопленочной структуры. Результатом этого исследования является подтверждение, доминирующего в настоящий момент филаментарного механизма, реализуемого в представленных в настоящей работе мемристорных структурах. Также продемонстрировано кратное увеличение отношения высокоомного состояния мемристора к низкоомному по сравнению с мемристорами, которые были изготовлены без медных дисков на титановой подложке в процессе магнетронного осаждения.
Полученные результаты показывают целесообразность использования представленной технологии осаждения диэлектрических материалов для изготовления резистивных элементов памяти.
Механизм влияния атомов меди на свойства мемристорных структур требует проведение отдельных исследований.
