ONE-WAY CONDUCTIVITY OF THE MEMRISTIVE STRUCTURE BASED ON ZIRCONIUM DIOXIDE NANOTUBES
ONE-WAY CONDUCTIVITY OF THE MEMRISTIVE STRUCTURE BASED ON ZIRCONIUM DIOXIDE NANOTUBES
Abstract
The anodizing technique was used to synthesize ZrO2 nanotubes with an outer diameter of 25 nm. Memristors with a Zr/ZrO2/Au layered structure were fabricated with magnetron sputtering. Current-voltage characteristics were measured in complete cycles of resistive switching. It has been demonstrated that the structure under study has unidirectional conductance. Considering the change in the electrical resistance of fabricated memristors under an applied voltage, it was concluded that Zr/ZrO2/Au memristors show high synaptic plasticity.
1. Введение
В настоящее время одним из перспективных направлений в создании нейрочипов, элементов нейровычислительных систем и искусственных нейронных сетей (ИНС) является разработка гибридных схем с аналого-цифровой архитектурой, совмещенной с кроссбар-структурой , , . В таких схемах нейроны изготавливают на основе обычных интегральных КМОП-транзисторов, аксонами и дендритами служат металлические проводники кроссбар-структуры. При этом роль синапсов выполняют двухполюсные мемристоры коммутационной матрицы в точках схождения проводников, которые соединяют пресинаптические и постсинаптические нейроны.
Как правило, связи между нейронами в существующем многообразии архитектур ИНС являются однонаправленными с точки зрения распространения возбуждения . В связи с этим перспективным представляется создание и исследование мемристивных структур металл/диэлектрик (полупроводник)/металл (МДМ-структур) с односторонней электрической проводимостью и возможностью ее варьирования при изменении прошедшего электрического заряда.
Ранее , , , эффект обратимого резистивного переключения наблюдался в МДМ-структурах на основе оксидов переходных металлов (TiO2, ZrO2, HfO2 и др.) различной морфологии, полученных методом электрохимического окисления. В таких твердотельных средах мемристивное поведение обеспечивается, как правило, подвижностью катионных или анионных вакансий в слое диэлектрика, а его толщина и дефектность определяют состояния с низким (LRS), промежуточным (IRS) и высоким (HRS) электрическими сопротивлениями , , . Известно, что анодные оксидные слои обладают сильной нестехиометрией по кислороду , , что и обеспечивает для них широкий диапазон изменения электрического сопротивления. Кроме того, подбор материала верхнего электрода позволяет получить МДМ-структуру с односторонней проводимостью за счёт образования диода Шоттки на границе металл/оксид .
Цель настоящей работы заключалась в изготовлении, аттестации сэндвич-структур с односторонней электрической проводимостью на основе массивов нанотубулярного диоксида циркония и исследовании их статических вольт-амперных характеристик.
2. Основные результаты
2.1. Изготовление МДМ-структуры
Мемристивная структура Zr/ZrO2/Au изготовлена с помощью методов анодирования металлического Zr и магнетронного напыления Au на поверхность оксидного слоя.
Металлическая фольга Zr толщиной 120 мкм, которая использовалась для синтеза поверхностного слоя ZrO2, предварительно промывалась ацетоном, обрабатывалась раствором кислот HF:HNO3:H2O = 1:6:20, промывалась дистиллированной водой и сушилась на воздухе. Процесс анодирования проводился в двухэлектродной ячейке при постоянном напряжении 20 В в течение 15 мин. Электролитом являлся раствор этиленгликоля, содержащий 5 мас. % H2O и 1 мас. % NH4F. Все химические реактивы были аналитической чистоты.
На поверхность полученного образца структуры Zr/ZrO2 наносились золотые контакты с помощью шаблона с отверстиями диаметром 1 мм на установке магнетронного напыления Q150T ES Quorum Technologies. Осаждение производилось в течение 500 с, в результате толщина напылённого слоя Au составила 50 нм. Таким образом, в рамках единого процесса были сформированы 100 мемристоров Zr/ZrO2/Au.
2.2. Аттестация ZrO2 и измерение ВАХ
Морфология синтезированных структур исследовалась с помощью сканирующего электронного микроскопа (СЭМ) SIGMA VP Carl Zeiss, оборудованного in-lens детектором в режиме высокого вакуума.
Измерения вольт-амперных характеристик (ВАХ) в статическом режиме проводились на оригинальной экспериментальной установке на основе микрозондовой станции Cascade Microtech MPS150 и управляемого модульного источника-измерителя NI PXIe‑4143. Циркониевая фольга заземлялась, а на Au-контакты подавался гармонический сигнал U(t) = U0 + Umsin(2pft) c частотой f = 0.01 Гц . Амплитуда приложенного напряжения Um и напряжение смещения U0 варьировались для изменения U(t) в диапазоне от –8 В до 8 В. Автоматизация процедуры измерения и сохранения экспериментальных данных осуществлялось с использованием виртуального прибора VI «CVC» в графической среде программирования LabVIEW .
2.3. Аттестация нанотубулярного массива ZrO2
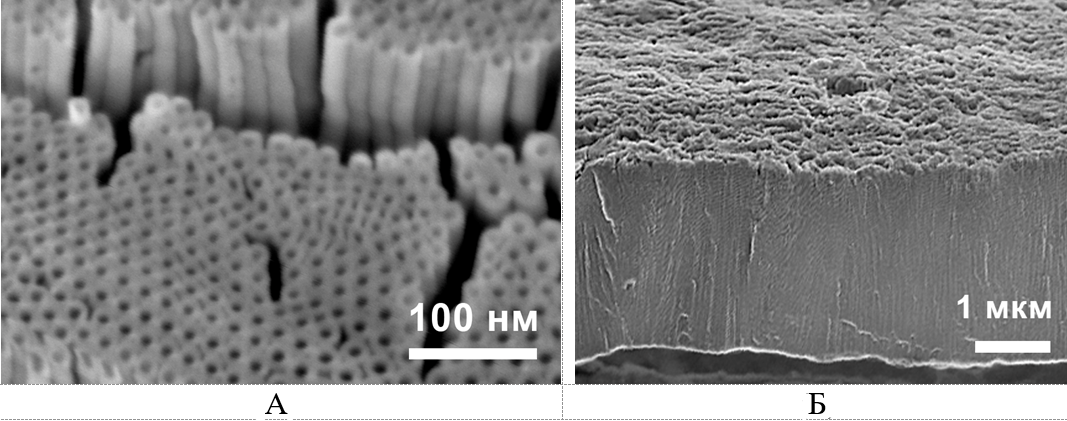
Рисунок 1 - Нанотубулярный массив диоксида циркония
Примечание: А – вид сверху; Б – вид сбоку

Рисунок 2 - Зависимости приложенного напряжения U (пунктирная линия) и протекающего тока I (сплошная линия) от времени t для мемристора Zr/ZrO2/Au

Рисунок 3 - Вольт-амперные характеристики резистивного переключения мемристора Zr/ZrO2/Au при U ≥ 0
Примечание: А) U0 = 2 В, Um = 6 В; Б) U0 = 0 В, Um = 8 В;
стрелками показано направление записи ВАХ; на вставке приведена эквивалентная схема исследуемой МДМ-структуры
Для исследуемой Zr/ZrO2/Au структуры выполнены оценки статического электрического сопротивления R в различных состояниях при U = 5 В: RHRS = (13 ± 1) кОм (состояние IRS с наибольшим сопротивлением), а значения RIRS варьируются от 5.2 до 0.35 кОм. При этом отношение RHRS / RLRS = 2–37, что свидетельствует о широком диапазоне изменения проводимости исследуемой мемристивной структуры.
3. Заключение
В настоящей работе методом анодирования выполнен синтез нанотубулярных структур ZrO2. С использованием сканирующей электронной микроскопии показано, что полученный оксидный слой имеет толщину 3 мкм и состоит из нанотрубок с внешним диаметром 25 нм.
Методом масочного магнетронного изготовлены мемристоры диаметром 1 мм со слоистой Zr/ZrO2/Au структурой. Для полученных мемристивных образцов исследованы ВАХ в полных циклах резистивного переключения при варьировании параметров приложенного гармонического напряжения. На основании анализа экспериментальных данных предложена эквивалентная электрическая схема с односторонней проводимостью в виде последовательного включения диода Шоттки и мемристора. Выполнены оценки электрических сопротивлений для мемристоров в высокоомном RHRS = (13.0 ± 1) кОм и промежуточных состояниях RIRS = (0.35–5.2) кОм. На основании полученных отношений RHRS / RIRS = 2–37 сделан вывод о высокой степени изменения проводимости изготовленной мемристивной структуры Zr/ZrO2/Au.
