STUDY OF PLASMA-CHEMICAL ETCHING OF THROUGH HOLES IN GaAs SHF MONOLITHIC INTEGRAL CIRCUITS IN A REACTOR WITH ICP SOURCE
STUDY OF PLASMA-CHEMICAL ETCHING OF THROUGH HOLES IN GaAs SHF MONOLITHIC INTEGRAL CIRCUITS IN A REACTOR WITH ICP SOURCE
Abstract
The present research is dedicated to the development of a technological process for plasma chemical etching of through-hole microwave monolithic integrated circuits (SHF MICs) based on GaAs in Cl2/BCl3 gas mixture.
Due to the high economic costs of this production, plasma chemical etching modelling was initially carried out to determine the optimal parameters: power delivered to the ICP source (PICP = 600 W); working gas pressure (p = 50 mTorr). The RF shift power applied to the substrate for anisotropic through-hole etching was then experimentally selected (PRF = 30 W).
A technological process of plasma chemical etching of through holes with an inclination angle α = 60º with lower diameter dmin = 30 μm and upper diameter dmax = 60 μm for GaAs etching depth h = 120 μm using ICP source was developed.
1. Введение
В современном производстве СВЧ микросхем существует тенденция увеличения степени интеграции элементов на подложке . На данный момент количество элементов на одной пластине GaAs достигает порядка 109 элементов. В связи с этим появляются трудности разварки проводников, которые вносят паразитные емкости и индуктивности. С целью решения данной проблемы были разработаны сквозные металлизированные отверстия с обратной стороны пластины , .
Наиболее сложным процессом по созданию металлизированных отверстий будет являться плазмохимическое травление GaAs с определенным диаметром сквозных отверстий , , поэтому целью данной научной работы является разработка технологического процесса плазмохимического травления сквозных отверстий с углом наклона α = 60º с нижним диаметром dmin = 30 мкм и верхним диаметром dmax = 60 мкм на глубину травления GaAs h = 120 мкм c использованием ICP-источника.
2. Методы и принципы исследования
Данное исследование состояло из двух этапов работы: моделирование плазмохимического травления в программном комплексе «Comsol Multiphysics» в реакторе с ICP-источником и проведение экспериментов.
Моделирование плазмохимического травления является комплексной задачей (см. рисунок 1), включающая моделирование в масштабе реактора и моделирование в масштабе структуры .
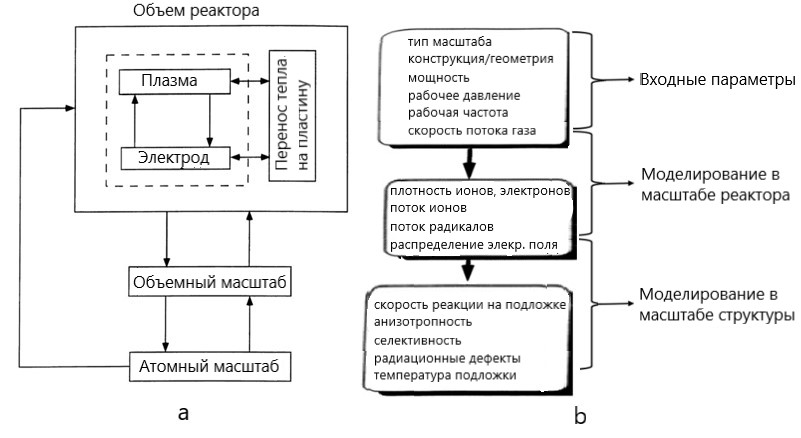
Рисунок 1 - Моделирование плазмохимического травления:
а) схема модели; b) порядок проведения расчета
Травление GaAs в основном проводится в хлор-фтористой плазме. Для изготовления сквозных отверстий могут быть использованы следующие газовых комбинаций CCl2F2, CCl2F2/CCl4, SiCl4/Cl2, BCl3/Cl2/Ar, Cl2/Ar и Cl2/BCl3.
Каждая газовая смесь имеет свои преимущества и недостатки. CCl2F2 привлекателен своей превосходной селективностью по отношению к металлу на лицевой стороне (Ti/Pt/Au, Cr) и отсутствием коррозии и токсичности, но скорость травления слишком низкая, и на протравленной поверхности, а также на стенках камеры происходит интенсивное образование полимеров, что приводит к плохой воспроизводимости процесса.
Для травления GaAs с использованием технологии ICP использовалась газовая смесь Cl2/BCl3 для изготовления сквозных отверстий. Данная газовая смесь обладает рядом преимуществом, а именно, высокая скорость травления, высокая анизотропия и гладкая морфология поверхности GaAs , .
3. Основные результаты
На равномерность распределения скорости травления по площади пластины влияют два основных параметра: давление газовой смеси и мощность ICP источника. Для подбора оптимальных параметров плазмохимического травления с точки зрения обеспечения максимальной скорости при сохранении равномерности процесса травления было проведено комплексное моделирование с диапазоном изменения давления p = 5 – 50 мТорр и диапазоном изменения мощности на ICP источнике PICP = 100 – 1000 Вт (см. рисунок 2).
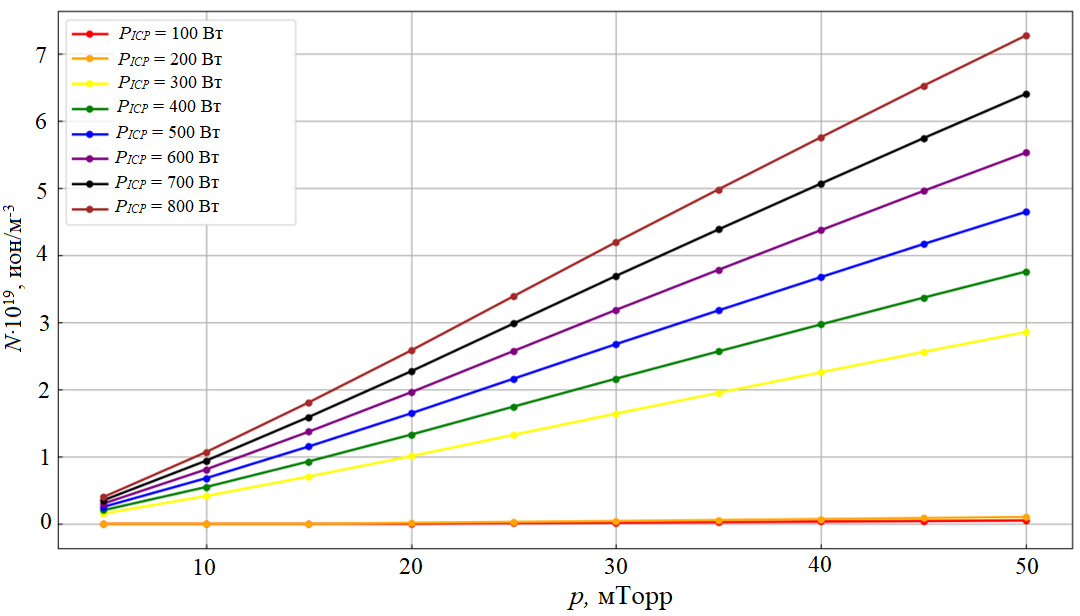
Рисунок 2 - Зависимость максимальной плотности ионов в плазме от давления газовой смеси при различной мощности ICP источника
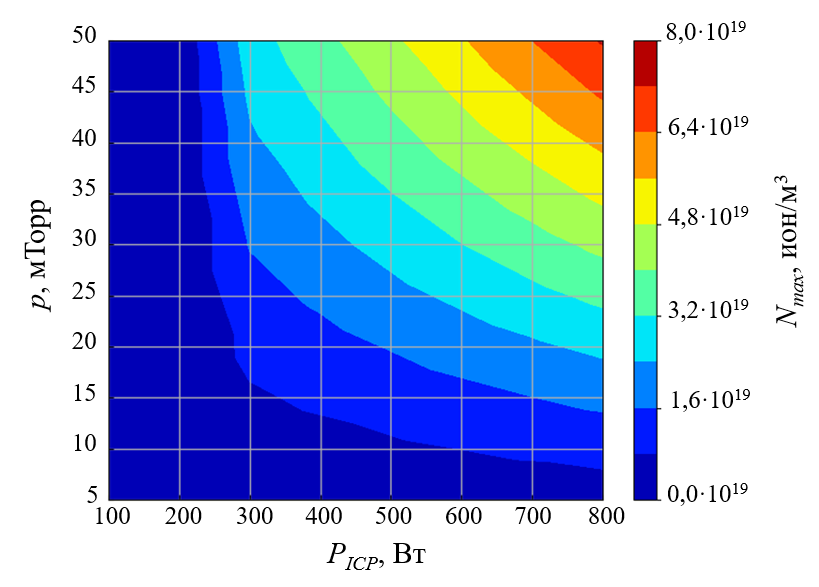
Рисунок 3 - Двумерная тепловая карта распределения максимальной плотности ионов в плазме от мощности и давления газовой смеси

Рисунок 4 - Двумерная тепловая карта распределения разброса концентрации ионов от центра к краю пластины от давления и мощности ICP источника
Таким образом, из моделирования плазмохимического травления в масштабе реактора были найдены следующие оптимальные параметры процесса: PICP = 600 Вт; p = 50 мТорр.
4. Основные результаты экспериментов
В рамках экспериментальной части были взяты оптимальные параметры, полученные при моделировании процесса PICP = 600 Вт; p = 50 мТорр с частотой RF-смещения 13,56 МГц для определения рабочей мощности смещения на подложку. На рис. 5 представлены результирующие профили травления в слое GaAs при различной мощности RF-смещения.
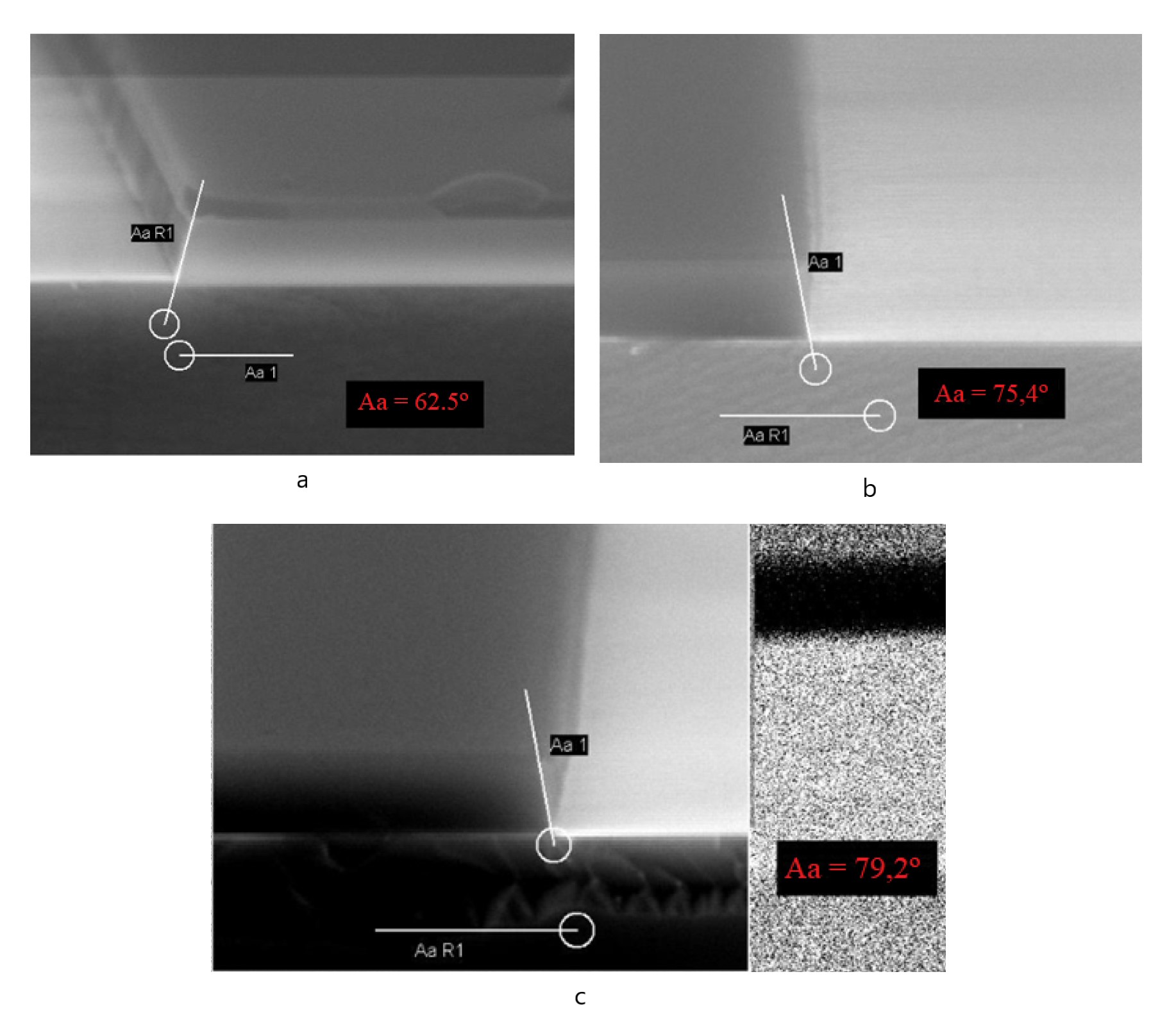
Рисунок 5 - Результирующие профили травления в слое GaAs при различной мощности RF-смещения:
а) PRF = 30 Вт; b) PRF = 45 Вт; c) PRF = 60 Вт
Таблица 1 - Значения параметров полученных профилей от мощности RF-смещения
№ | PRF, Вт | α, град | Vтр, нм/мин | S |
1 | 30 | 62,5 | 65,53 | 1,814 |
2 | 45 | 75,4 | 78,25 | 1,267 |
3 | 60 | 79, 2 | 84,8 | 1,122 |
Из таблицы 1 видно, что с ростом подаваемой RF-мощности увеличивается угол наклона боковых стенок и скорость травления GaAs. При этом селективность травления GaAs к слою маски уменьшается. Исходя из технических требований к углу наклона боковых стенок в α = 60º, наиболее подходящим является режим №1. Таким образом, оптимальная мощность RF-смещения равна PRF = 30 Вт.
На рис. 6 представлен профиль травления отверстий в подложке GaAs при оптимальных параметрах.
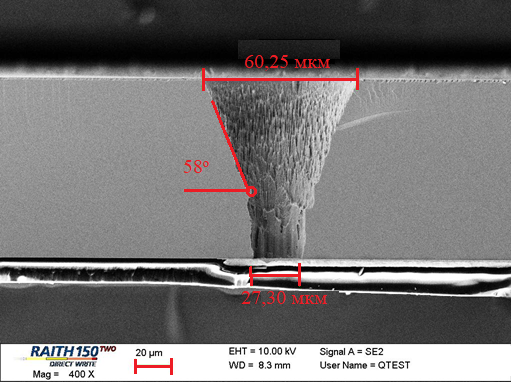
Рисунок 6 - Профиль травления отверстий в подложке GaAs при оптимальных параметрах процесса травления
5. Заключение
В ходе работы был разработан технологический процесс плазмохимического травления сквозных отверстий с углом наклона α = 60º с нижним диаметром dmin = 30 мкм и верхним диаметром dmax = 60 мкм на глубину травления GaAs h = 120 мкм c использованием ICP-источника.
Из результатов моделирования плазмохимического травления в масштабе реактора было получено, что с увеличением мощности и давления газовой смеси увеличивается максимальная концентрация ионов в плазме. Распределение разброса концентрации ионов в плазме прямо пропорционально связано с распределением скорости травления подложки. Максимальная мощность, которая может быть подана на ICP источник, для обеспечения разброса скорости травления по подложке менее 5 % составляла около PICP = 600 Вт. Давление газа при этом было выбрано максимальным p = 50 мТорр для сохранения высокой скорости травления.
На основе рассчитанных оптимальных параметров процесса плазмохимического травления было выполнено экспериментальное получение сквозных отверстий в GaAs. В результате размер отверстия в верхней плоскости составил dmax = 60,25 мкм, в нижней плоскости – dmin = 27,30 мкм, а угол наклона боковых стенок α = 58º. Таким образом, полученные результаты соответствуют требованиям технического задания.
