МОДЕЛИРОВАНИЕ ЭЛЕКТРОННО-ОПТИЧЕСКИХ ПРОЦЕССОВ В ДИОДЕ НА ОСНОВЕ СТРУКТУРЫ N +-SI/ N-SI:ER/ P +-SI ПРИ ОБРАТНОМ СМЕЩЕНИИ И ПУТИ ПОВЫШЕНИЯ ДОСТОВЕРНОСТИ МОДЕЛИРОВАНИЯ СТРУКТУР
Зимовец И. А.1, Филатов Д. О.2,
1аспирант ННГУ; к.ф.-м.н., 2доцент, НОЦ ФТНС ННГУ,
МОДЕЛИРОВАНИЕ ЭЛЕКТРОННО-ОПТИЧЕСКИХ ПРОЦЕССОВ В ДИОДЕ НА ОСНОВЕ СТРУКТУРЫ N +-SI/ N-SI:ER/ P +-SI ПРИ ОБРАТНОМ СМЕЩЕНИИ И ПУТИ ПОВЫШЕНИЯ ДОСТОВЕРНОСТИ МОДЕЛИРОВАНИЯ СТРУКТУР
Аннотация
Развита математическая модель, описывающая процессы возбуждения электролюминесценции ионов Er3+ в диодах на основе структуры n+-Si/n-Si:Er/p+-Si при обратном смещении. Модель учитывает процессы туннельной инжекции электронов из валентной зоны слоя p+-Si на глубокие уровни, связанные с примесью Er в активном слое n-Si:Er.
Ключевые слова: моделирование, электронно-оптические процессы, диод.
Keywords: modelation, electron optic process, diod.
В большинстве работ по эрбиевой электролюминесценции (ЭЛ) в структурах Si/Si:Er/Si с p—n переходом в режиме пробоя при обратном смещении для объяснения наблюдаемых эффектов предполагается, что возбуждение ЭЛ на длине волны l » 1,54 мкм в 4f-оболочке ионов эрбия обусловлено передачей им энергии горячими электронами зоны проводимости. Требуемую энергию (не менее 0,8 эВ) электроны могут набирать при взаимодействии с электрическим полем в области пространственного заряда (ОПЗ) p—n перехода. Однако, как показано в работе [1], такая модель содержит противоречия с результатами экспериментов. Там же предложена качественно новая модель, основанная на предположении, что возбуждение излучательных переходов в 4f-оболочке ионов эрбия обусловлено передачей им энергии, освобождаемой в результате безызлучательных переходов электронов с глубоких донорных состояний, образуемых комплексами эрбия в запрещенной зоне кремния, на нейтральные мелкие акцепторы (B, Al или Ga) с концентрацией на уровне ~ 1017 см‑3 в слоях Si:Er, выращенных методом сублимационной молекулярно-лучевой эпитаксии (СМЛЭ). Такая модель хорошо применима для качественного объяснения наблюдаемых экспериментальных эффектов, но ряд ее положений требует доказательств.
Диффузионно-дрейфовая модель диода в стационарном состоянии состояла из пяти уравнений фундаментальной системы уравнений физики полупроводников (ФСУ) — стационарных уравнений непрерывности для электронов и дырок и уравнения Пуассона, которые задают взаимосвязь между пятью основными характеристиками диода :концентрации электронов и дырок, дырочный и электронный токи, также напряженность электрического поля. Зонная диаграмма перехода p+-Si/n-Si:Er рассчитывалась на базе решения уравнения Пуассона:

где  —профиль потенциаладля электронов,
—профиль потенциаладля электронов,  —диэлектрическая проницаемость Si,
—диэлектрическая проницаемость Si,  —диэлектрическая постоянная, е—элементарный заряд,
—диэлектрическая постоянная, е—элементарный заряд,


—концентрация дырок в валентной зоне, Nv—эффективная плотность состояний в валентной зоне Si, Fp—квазиуровень Ферми для дырок,  —постоянная Больцмана, Т—абсолютная температура,
—постоянная Больцмана, Т—абсолютная температура,

—интеграл Ферми порядка ½,

—концентрация электронов в зоне проводимости,  —эффективная плотность состояний в зоне проводимости Si,
—эффективная плотность состояний в зоне проводимости Si,  —квазиуровень Ферми для электронов В этом случае решение уравнения Пуассона:
—квазиуровень Ферми для электронов В этом случае решение уравнения Пуассона: 

— толщина части ОПЗ, приходящаяся на слой p+-Si, Vp — доля контактной разности потенциалов р+—n перехода падающая на ОПЗ слоя p+-Si
падающая на ОПЗ слоя p+-Si  , где Vn — доля
, где Vn — доля  падающая на части ОПЗ, лежащей в слое n-Si:Er, Ecp и Ecn — энергии дна зоны проводимости в квазинейтральных областях слоёв p+-Si и n-Si:Er (области I и IV, соответственно). На границе квазинейтральной области слоя n-Si:Er (z = ln) условие квазинейтральности записывалось в виде:
падающая на части ОПЗ, лежащей в слое n-Si:Er, Ecp и Ecn — энергии дна зоны проводимости в квазинейтральных областях слоёв p+-Si и n-Si:Er (области I и IV, соответственно). На границе квазинейтральной области слоя n-Si:Er (z = ln) условие квазинейтральности записывалось в виде: ,что даёт
,что даёт

Рассматривался процесс туннельной инжекции электрона из валентной зоны на глубокий центр с координатой  Форма потенциальной ямы глубокого центра аппроксимировалась водородоподобной моделью:
Форма потенциальной ямы глубокого центра аппроксимировалась водородоподобной моделью:

где eeff = (Ry/Ed)1/2 — эффективная диэлектрическая проницаемость, Ry  13,6 эВ — потенциал ионизации атома водорода (постоянная Ридберга).
13,6 эВ — потенциал ионизации атома водорода (постоянная Ридберга).
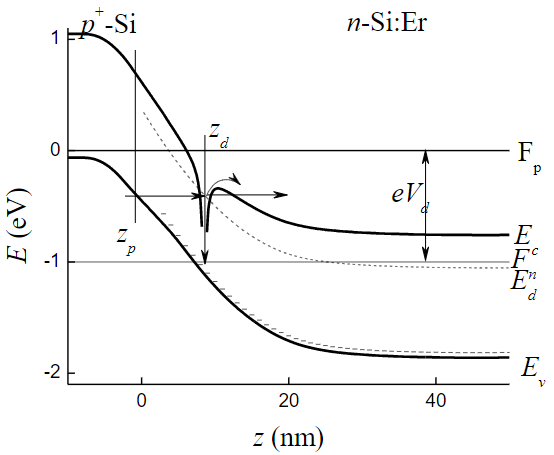
Рис. 1. Расчётная зонная диаграмма структуры p+-Si/ n-Si:Er (300К) при приложении обратного смещения Vd = 1 В. NEr = 3×1018 cм–3, Ed = 0,3 эВ
Все уравнения модели являются дифференциальными уравнениями первого порядка в частных производных. Модель требует постановки пяти граничных условий. В литературе методы, посвященные моделированию полупроводниковых структур предлагают задавать граничные условия следующим образом: четыре условия получаются фиксированием концентраций дырок и электронов на обеих контактах структуры, в качестве пятого условия берется равенство разности потенциалов но границах и интеграла от напряженности поля. Иногда полагается равной нулю напряженность поля на границах ( полагается , что вне структуры , в металле ,падение напряжения мало, по сравнением с падением его в диоде), накладываются упрощающие ограничения на токи, пятое, интегральное условие при этом сохраняется. Однако при использовании этих условий возникает проблема несовместимости граничных условий с самой системой – когда уравнение наряду с диссипативным членом содержит и конвективный, что сильно усложняет задачу численного интегрирования. Модель структуры приходится применять либо в слоистых средах, в которых свойства материалов меняются скачкообразно, либо в средах с непрерывно, но очень быстро меняющимися свойствами. Сами величины, участвующие в модели могут иметь большие градиенты. это приводит к трудностям в построении устойчивого алгоритма численного решения, точное решение может быть не гладким или не непрерывным, что требует применения надежных численных методов.
При решении системы дифференциальных уравнений в частных производных использовалось расширение математического пакета Matlab – пакет FEMLAB. При решении систем дифференциальных уравнений в частных производных система FEMLAB использует метод конечных элементов. Программное обеспечение выполняет конечноэлементный анализ вместе с адаптивным построением сетки, используя целый ряд численных решателей. Большой интерес представляет реализация в среде FEMLAB новый тип разностных схем – бикомпактные схемы. Решение задач в слоистых средах сложно тем, что трудно построить аппроксимацию, дающую высокий порядок точности на стыках сред. Если задавать сетку так, что граница сред лежит между узлами сетки, то построить аппроксимацию сложно, и приходится выбирать сетку так, чтобы ее узлы попадали на границы слоев (такие сетки называются специальными). Если шаблон аппроксимации содержит три и более пространственных узла, то специальные сетки не спасают - если внутренний узел шаблона совпадает с границей, то аппроксимация производных идет через разрыв коэффициентов- ухудшается точность расчетов. Использование в расчете полуцелых узлов приводит к такому же эффекту. Использование бикомпактных схем (шаблон состоит из двух узлов сетки, полуцелые точки в расчетах не участвуют) позволяет достигнуть высокой точности расчета.
Список литературы
В.Х. Кудояров, А.Н. Кузнецов, Е.И. Теруков, О.Б. Гусев, Ю.А. Кудрявцев и др. Влияние кислорода на интенсивность фотолюминесценции Er ( 1.54 мкм) в пленках –Si:H, легированных эрбием. ж. Физика и техника полупроводников,1998,том 32,No11
Н.А. Соболев Кремний, легированный эрбием,-новый полупроводниковый материал для оптоэлектроники. Ж. Рос. хим. общ-ва им.Д.И. Менделеева,2001,т. , No5-6
В.Г. Шенгуров, С.П. Светлов, В.Ю. Ччалков, Г.А. Максимов, З.Ф. Красильник и др. Солегирование эрбием и кислородом кремниевых слоев в процессе молекулярно-лучевой эпитаксии. . ж. Физика и техника полупроводников,2001,том 35, вып.8
А.А. Андреев, В.Б. Воронков, В.Г. Голубев, А.В. Медведев, А.Б. Певцов Влияние термического отжига на интенсивность полосыфотолюминесценции 1,54 мкм в легированном эрбием гидрогенизированном аморфном кремнии. ж.Физика и техника полупроводников,1999,том 33,No1
Список литературы
В.Х. Кудояров, А.Н. Кузнецов, Е.И. Теруков, О.Б. Гусев, Ю.А. Кудрявцев и др. Влияние кислорода на интенсивность фотолюминесценции Er ( 1.54 мкм) в пленках –Si:H, легированных эрбием. ж. Физика и техника полупроводников,1998,том 32,No11
Н.А. Соболев Кремний, легированный эрбием,-новый полупроводниковый материал для оптоэлектроники. Ж. Рос. хим. общ-ва им.Д.И. Менделеева,2001,т. , No5-6
В.Г. Шенгуров, С.П. Светлов, В.Ю. Ччалков, Г.А. Максимов, З.Ф. Красильник и др. Солегирование эрбием и кислородом кремниевых слоев в процессе молекулярно-лучевой эпитаксии. . ж. Физика и техника полупроводников,2001,том 35, вып.8
А.А. Андреев, В.Б. Воронков, В.Г. Голубев, А.В. Медведев, А.Б. Певцов Влияние термического отжига на интенсивность полосыфотолюминесценции 1,54 мкм в легированном эрбием гидрогенизированном аморфном кремнии. ж.Физика и техника полупроводников,1999,том 33,No1
